功率半导体器件IGBT芯片测试总结
硅基的两种方法IGBT适用性好,尤其是阈值电压法VGE,th(T)在测量延迟带来的温度修正方面具有一定的优势;不同的电流激励方法对设备的加热能力、故障机理和寿命有不同程度的影响DC功率循环是最简单的,但缺乏开关损耗使某些设备的测试电流过大,带有开关损耗DC功率循环可以有效地解决这个问题。
根据电力循环的基本原理,结合电力循环的测试需求和国内外的研究现状,深入分析了电力循环测试技术的挑战,得出以下结论。在功率循环测试技术方面,核心应突破电气测量噪声、测量延迟和数据采集点三个技术难点。

电气测量噪声是影响设备结温准确测量的最关键影响。一方面需要高精度、高频测量系统,另一方面需要控制振荡范围,减少温度测量的干扰;测量延迟是大电流切断后半导体器件重要的载流子恢复时间,与器件本体和测试条件有关。考虑结温测量误差和延迟时间造成的校正需要在测试前确认;
数据采集点是影响设备故障模式判断和使用寿命的设备。要确定键合线的老化状态,必须解耦结温对压降的影响。在功率循环测试方法方面,核心方法应突破温度测量、电流激励和SiCMOSFET设备测试挑战。饱和压降法综合对比分析VCE(T)阈值电压法VGE,th(T)测试电路、结果准确性和适用性的基本原理,探讨了阈值电压漂移对测量结果的影响。
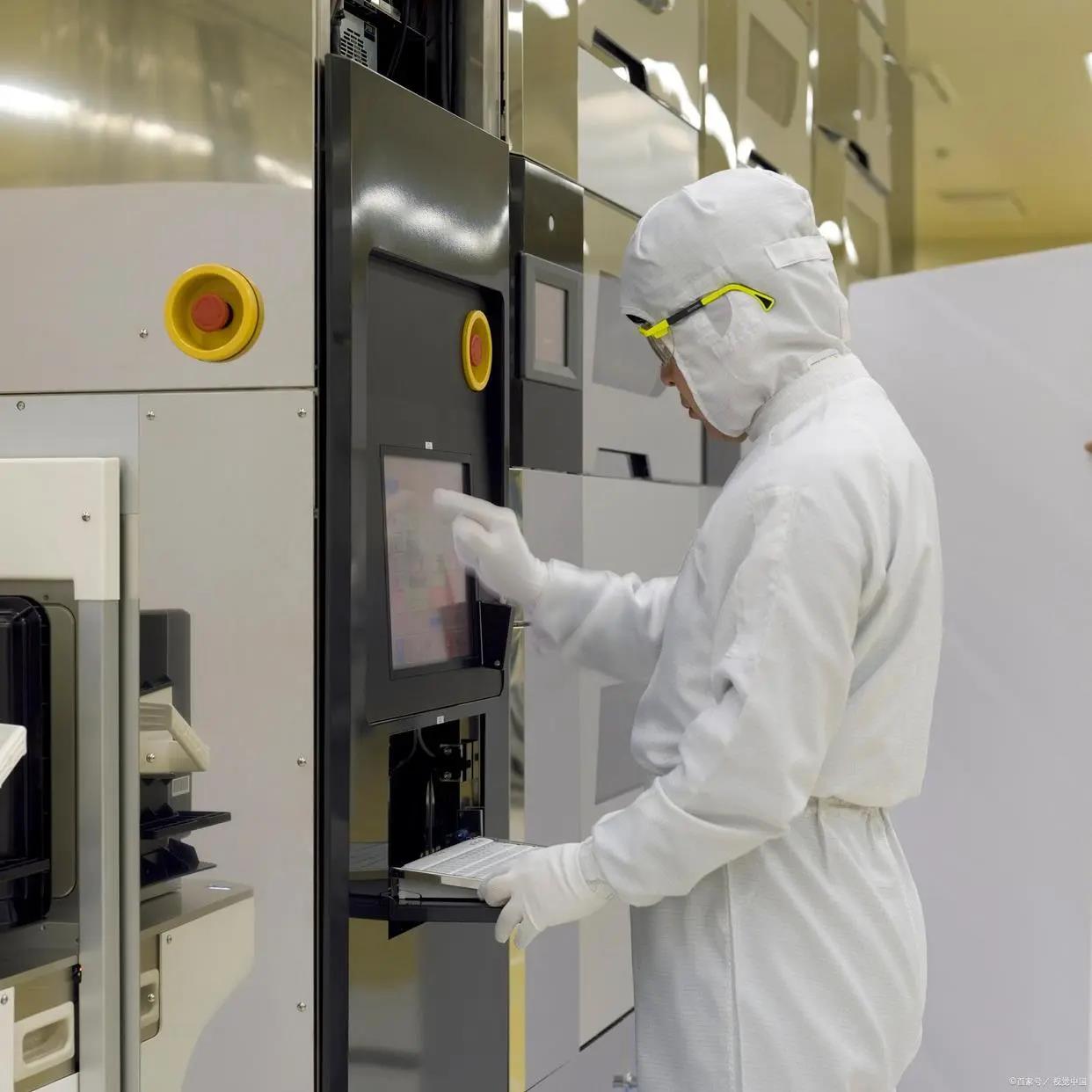
需要注意的是,基于阈值电压激励的方法可能会改变故障机制和寿命,只适用于单个芯片。多芯片并联模块值电压的负温度特性,多芯片并联模块电流分布不均匀;SiCMOSFET功率设备需要关注阈值电压漂移引起的温度测量和功率循环方法,特别是温度测量不成熟,反并联二极管SiCMOSFET目前还没有成熟的模块方法。
在数据处理方面,要注意测量延迟引起的温度测量误差及其修正。同时,还应考虑开关时间和测试电流对实际测试寿命的影响,特别是键合线故障的设备。这是因为器件内部的键合线不仅被芯片加热,还来自于键合线本身通过电流产生的焦耳热,极大地影响了键合线的使用寿命。

从随机性和偶然性的角度来看,同一批测试的样本最好为6~12个,然后根据6个设备的功率循环寿命进行威布尔分布数理统计。在鸿怡电子HMILU测试座socket实际运用中,从提供的老化测试座、功率测试座、大电流测试座、SMD器件测试座、IGBT测试座、DC电源芯片测试座等不同的实际测试过程中,所反馈的良率均比较满意。


